Intel 近日在日本 NEPCON 展會上,公開展示結合 EMIB 先進封裝技術的「玻璃核心(Glass Core)基板」,被視為次世代 AI 與 HPC 晶片的重要關鍵技術之一,也間接回應了外界對其是否放棄玻璃基板布局的質疑。
所謂玻璃基板,被視為傳統有機基板的潛在替代方案,能在更大尺寸封裝中提供更高佈線密度與結構穩定性。Intel 此次展出的為一款「厚核心(Thick Core)」玻璃基板,整合於 EMIB(Embedded Multi-die Interconnect Bridge)封裝架構之中,官方強調該設計主要鎖定資料中心與伺服器級應用。
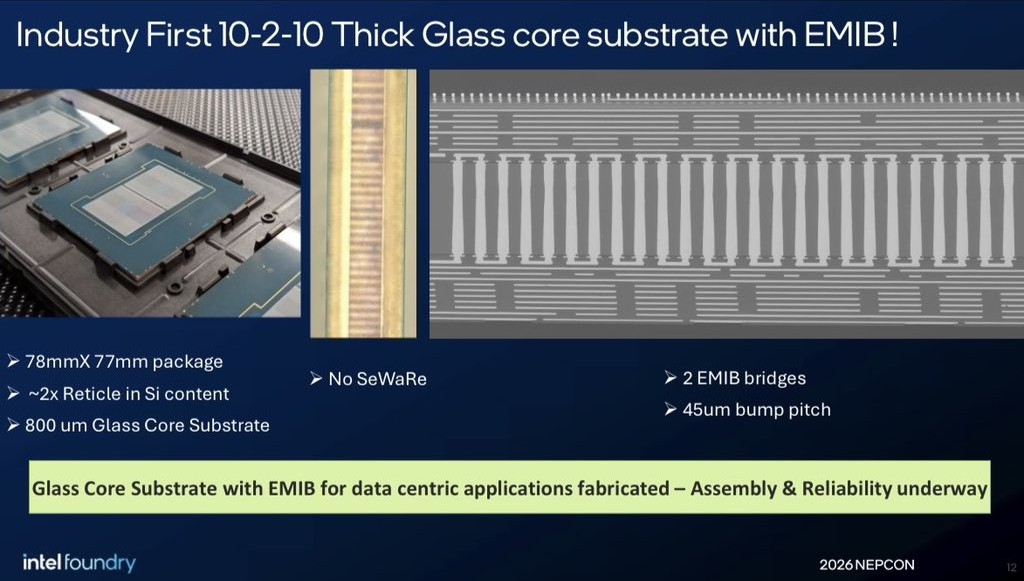
這項展示之所以引發關注,原因在於先前曾有傳聞指出,Intel 在關鍵人員離職後,已放緩甚至中止玻璃基板相關計畫。不過從此次實際展出的成果來看,Intel 不僅未放棄該方向,反而率先展示目前業界首見的「玻璃基板+EMIB」實作。
從技術細節來看,該封裝方案可支援約兩倍光罩尺寸,整體封裝大小達 78mm × 77mm,垂直堆疊採用 10-2-10 架構,包含 10 層 RDL、2 層玻璃核心以及 10 層下方建構層。即便在如此高密度結構下,玻璃材料仍能維持精細佈線能力,這正是其相較傳統基板的關鍵優勢之一。封裝內部亦已整合兩組 EMIB 橋接,用於多顆運算晶粒之間的高速互連。
從封裝尺寸與設計標示來看,該方案明顯針對 AI 加速器等伺服器級產品而來。玻璃基板所帶來的細線化能力、更佳的景深控制與較低的機械應力,被認為是未來打造「多晶粒超級封裝」的重要基礎,對於 AI 架構持續擴大規模具有關鍵意義。
隨著先進封裝產能成為 HPC 與 AI 產業的瓶頸之一,EMIB 近年來受到不少業者關注。Intel 此次在玻璃基板上的進一步展示,也顯示其希望藉由封裝技術切入新一波成長動能。若相關技術持續成熟,先進封裝有望成為 Intel 未來的重要營收支柱之一。
來源
所謂玻璃基板,被視為傳統有機基板的潛在替代方案,能在更大尺寸封裝中提供更高佈線密度與結構穩定性。Intel 此次展出的為一款「厚核心(Thick Core)」玻璃基板,整合於 EMIB(Embedded Multi-die Interconnect Bridge)封裝架構之中,官方強調該設計主要鎖定資料中心與伺服器級應用。
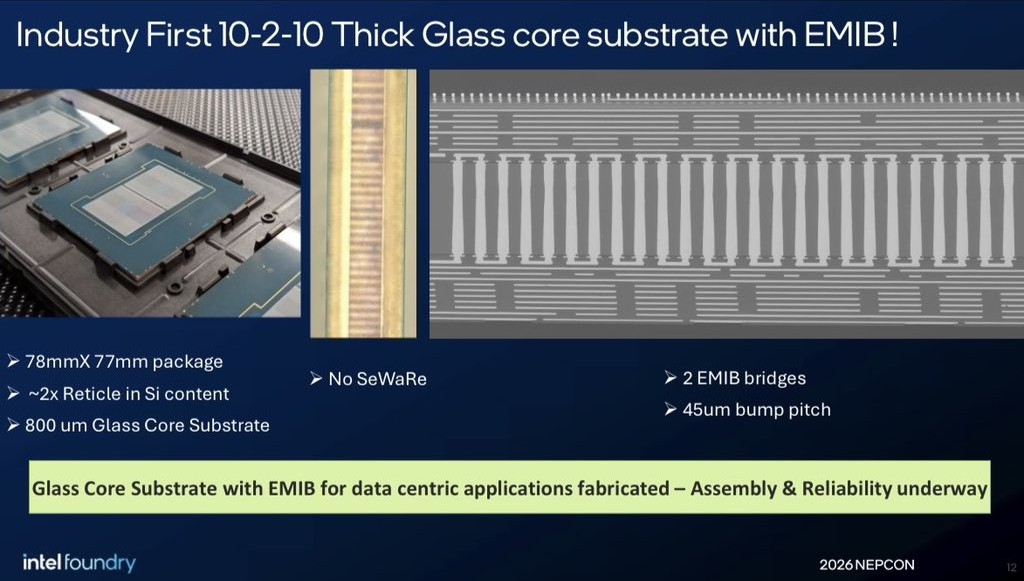
這項展示之所以引發關注,原因在於先前曾有傳聞指出,Intel 在關鍵人員離職後,已放緩甚至中止玻璃基板相關計畫。不過從此次實際展出的成果來看,Intel 不僅未放棄該方向,反而率先展示目前業界首見的「玻璃基板+EMIB」實作。
從技術細節來看,該封裝方案可支援約兩倍光罩尺寸,整體封裝大小達 78mm × 77mm,垂直堆疊採用 10-2-10 架構,包含 10 層 RDL、2 層玻璃核心以及 10 層下方建構層。即便在如此高密度結構下,玻璃材料仍能維持精細佈線能力,這正是其相較傳統基板的關鍵優勢之一。封裝內部亦已整合兩組 EMIB 橋接,用於多顆運算晶粒之間的高速互連。
從封裝尺寸與設計標示來看,該方案明顯針對 AI 加速器等伺服器級產品而來。玻璃基板所帶來的細線化能力、更佳的景深控制與較低的機械應力,被認為是未來打造「多晶粒超級封裝」的重要基礎,對於 AI 架構持續擴大規模具有關鍵意義。
隨著先進封裝產能成為 HPC 與 AI 產業的瓶頸之一,EMIB 近年來受到不少業者關注。Intel 此次在玻璃基板上的進一步展示,也顯示其希望藉由封裝技術切入新一波成長動能。若相關技術持續成熟,先進封裝有望成為 Intel 未來的重要營收支柱之一。
來源


