Intel Foundry 近期在一篇名為《A Novel Disaggregated Approach of Assembling Integrated Heat Spreader for Advanced Packages》的研究論文中,揭露了一種全新的散熱蓋(IHS)組裝方式。這項做法主打模組化設計,能讓散熱蓋更容易製造、成本更低,同時提升高功耗晶片的散熱能力。

這項設計是針對 Intel 的先進封裝技術而生,尤其是內含多顆晶粒、堆疊結構更複雜的超大型封裝晶片。透過將傳統的一體成型散熱蓋拆分為多個簡單零件,再以標準封裝流程進行組裝,Intel 表示可帶來多項改善:
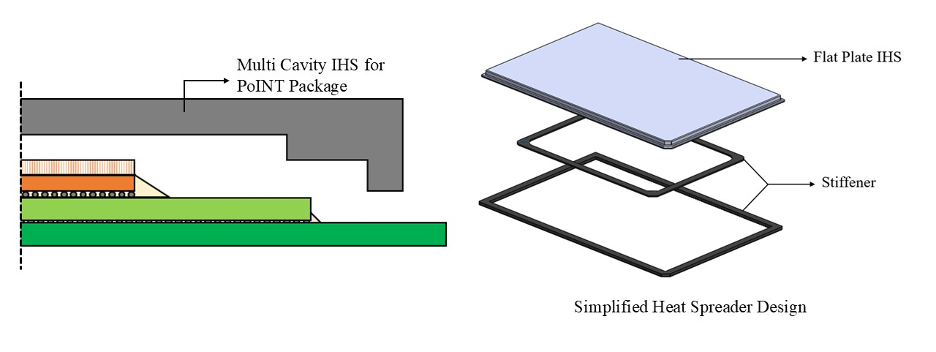
在現行高階 CPU、GPU 上,散熱蓋通常是一整塊金屬,需以特製衝壓成型製作出複雜凹槽,以貼合不同晶片堆疊位置。但隨著晶片封裝面積突破 7000 mm²,這類設計變得愈加繁瑣,傳統衝壓甚至無法製作,需要改用 CNC 等昂貴工法,增加成本與生產時間。
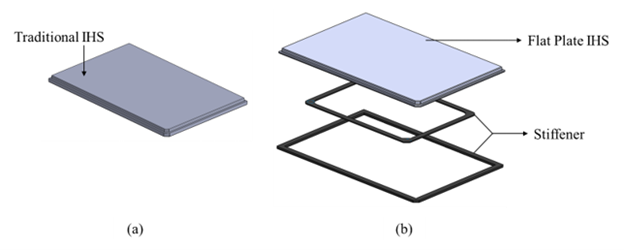
Intel 的新方案則把複雜設計拆解成多個簡單部件,例如:

研究指出,此方式還能讓散熱蓋的共面度提升約 7%,也就是整體平整度更好,有助於改善散熱接觸品質。
Intel 表示,這項拆解式散熱蓋方法將成為未來製造超大型晶片封裝的重要一步驟,尤其是在多chiplet、3D 堆疊與高功耗運算領域。
研究團隊也正在評估如何把此技術擴展至更多散熱方案,包括:
簡單來說,這項研究不只是讓散熱蓋變便宜,而是替 Intel 的下一代大型封裝設計打開更多可能。
來源

這項設計是針對 Intel 的先進封裝技術而生,尤其是內含多顆晶粒、堆疊結構更複雜的超大型封裝晶片。透過將傳統的一體成型散熱蓋拆分為多個簡單零件,再以標準封裝流程進行組裝,Intel 表示可帶來多項改善:
- 封裝翹曲(warping)減少最高 30%
- 導熱介面材料(TIM)空隙降低約 25%
- 散熱能力提升,適用於高功耗晶片
- 可支援更大型、傳統方法無法製造的封裝尺寸
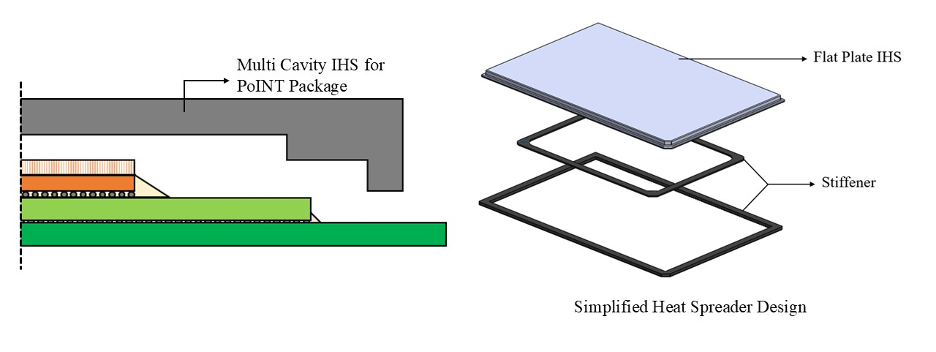
傳統散熱蓋遇到瓶頸,Intel 用「拆解式 IHS」突破限制
在現行高階 CPU、GPU 上,散熱蓋通常是一整塊金屬,需以特製衝壓成型製作出複雜凹槽,以貼合不同晶片堆疊位置。但隨著晶片封裝面積突破 7000 mm²,這類設計變得愈加繁瑣,傳統衝壓甚至無法製作,需要改用 CNC 等昂貴工法,增加成本與生產時間。
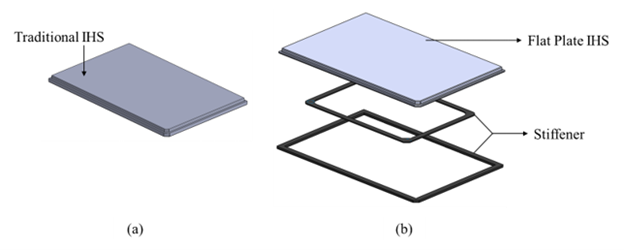
Intel 的新方案則把複雜設計拆解成多個簡單部件,例如:
- 平整金屬板:作為主要散熱面
- 加強框架(stiffener):提供結構強度並形成所需腔體
- 優化膠材:提升 TIM 表現

研究指出,此方式還能讓散熱蓋的共面度提升約 7%,也就是整體平整度更好,有助於改善散熱接觸品質。
為未來作準備:超大型封裝與進階散熱
Intel 表示,這項拆解式散熱蓋方法將成為未來製造超大型晶片封裝的重要一步驟,尤其是在多chiplet、3D 堆疊與高功耗運算領域。
研究團隊也正在評估如何把此技術擴展至更多散熱方案,包括:
- 高導熱金屬複合散熱蓋
- 與液冷系統整合的散熱模組
簡單來說,這項研究不只是讓散熱蓋變便宜,而是替 Intel 的下一代大型封裝設計打開更多可能。
來源











